プロダクト
半導体パッケージ基板:薄膜キャパシタ(TFC)内蔵
 GigaModule-ECとは
GigaModule-ECとは
「業界が切望していた、薄膜キャパシタ(TFC : Thin Film Capacitor)内蔵サブストレートの量産化に成功。半導体にきわめて近い位置にバイパスキャパシタを配置できることから、従来にないレベルでの大容量・低インダクタンスを実現します。半導体製品の超小型化と電源安定性という相反する要求にこたえる、新世代サブストレート「GigaModule-EC」は、ハイエンド系からモバイル系まで、幅広い製品の開発に寄与します。
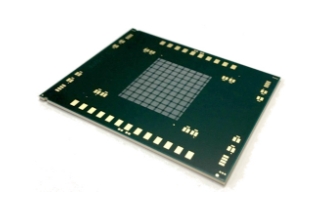
GigaModule-2EC
(注)TFC内蔵には、ソニーセミコンダクタソリューションズ株式会社と共同開発した技術が使用されています。
 厳しい開発要件に頭を抱えていませんか?
厳しい開発要件に頭を抱えていませんか?

- 高周波領域の電源ノイズによって、性能を出しきれない
- 動作電圧の低電圧化に伴う、動作時の電圧降下やノイズをどうにかしたい
- 必要な静電容量に対応する適切なキャパシタを搭載したい
- 大容量キャパシタを必要とするが、載せるスペースがない

 GigaModule-ECが解決する
GigaModule-ECが解決する
4つの課題
課題 01
高周波領域に効果大
GigaModule-ECは、高周波駆動、低電圧化に対応した、高周波領域でのインピーダンス特性に優れたTFCを内蔵しています。大容量・低インダクタンスなTFCとチップ間の距離を短縮できることから、両者間のインダクタンスが低減されます。接続するVia の数を増やせば、さらにインダクタンスの低減が図れ、実証実験では、低周波領域から高周波領域までインピーダンスの低減が確認されています。外付けのコンデンサでは難しかった、高周波領域でのノイズを押さえることが可能になったのです。これにより、半導体の周波数特性が大きく改善され、チップ性能を最大限引き出すことが期待できます。
TFC内蔵による
V/G 間インピーダンスの変化

解析仕様

課題 02
電圧降下対策に効果大
半導体の低電圧化が進み、動作時の電圧降下対策がどんどん難しくなっています。高周波領域に対応したTFC内蔵のサブストレートであれば、半導体の近傍にキャパシタを設置し、電源層間に接続して充放電させることができます。これにより、電圧のふらつきが低減され、安定した高パフォーマンスが期待できます。
課題 03
静電容量を自由に設定可能
内蔵可能なTFCは、1.0μF/cm²の高容量タイプ。基板内の全面に層として内蔵されています。このため、静電容量をニーズに合わせて自由にパターン設計で設定し、エッチングで加工することが可能です。つまり、TFC内蔵技術により設計段階で自由度が生まれ、従来では不可能とされていた設計の可能性が期待できるのです。
課題 04
実装領域を有効に利用
サブストレートにTFCが内蔵されているため、チップの表面に搭載するキャパシタ数を大幅に削減でき、実装領域を有効に使用することができます。また、狭ピッチでVia の接続・通過が可能ですので、配線性への影響も少ないのも大きな特徴です。