プロダクト
ビルドアップ基板
 ビルドアップ基板について
ビルドアップ基板について
最新の情報通信機器に代表される高性能・高速伝送機器向けなどに、
設計・実装シミュレーションから基板製造までのトータルソリューションをご提供します。
 課題例・解決方法
課題例・解決方法
最新の情報通信機器やモジュールの高性能化の要求に対応するため、
プリント基板だけでなく機器全体へのソリューションでお客様のお困りを解決します。
課題 01
製品サイズを従来比50%以下にしたい
製品の小型化を実現するため、プリント基板に要求される高剛性、薄型、軽量な材料での最適なプリント基板を提案します。省スペース化に伴う高密度実装基板の反り問題や部品接合部の高信頼性設計へ応力シミュレーションをご提案します。
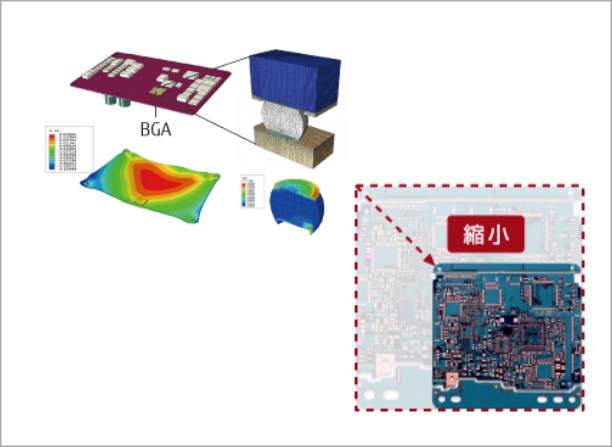
こちらの課題を解決するための物理系シミュレーション:「実装応力解析」詳細を見る
実装応力解析
課題 02
製品の小型化で引き起こされる発熱対策を行いたい
熱・流体シミュレーション技術を駆使して、製品の小型化で課題となるヒートスポットの放熱対策など、機能とコストの最適バランスを追求した、最適な構造や冷却方式を提案します。
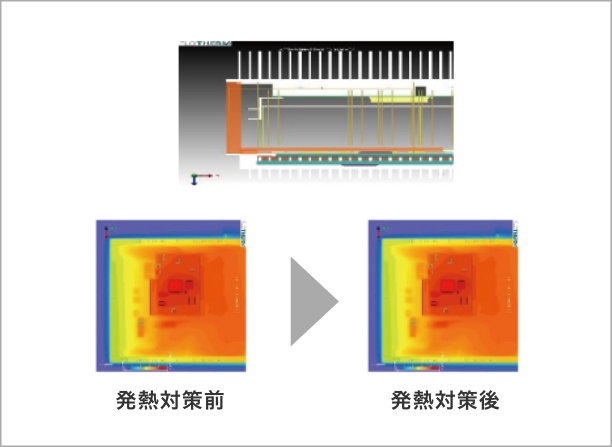
こちらの課題を解決するための物理系シミュレーション:「冷却解析」詳細を見る
冷却解析
 適用事例
適用事例
高信頼性が要求される高性能・高速伝送機器向けの一例を紹介します。
事例 01
通信機器向けビルドアップ基板
| 層構成 | 3-6-3 |
|---|---|
| Via径 | Φ0.10mm |
| Line/Space | 100µm/100µm (内層 80µm/100µm) |
事例 02
ハンディターミナル向けビルドアップ基板
| 層構成 | 1-8-1 |
|---|---|
| Via径 | Φ0.08mm |
| Line/Space | 75µm/100µm (内層 75µm/75µm) |

事例 03
半導体関連機器向けビルドアップ基板
| 層構成 | 1-28+28-1 |
|---|---|
| Via径 | Φ0.10mm |
| Line/Space | 100µm/150µm (内層 76µm/150µm) |

 基板仕様
基板仕様
- ビルドアップ ~ 3-n-3
- ビアメニュー フィルドビア、スタックドビア、他
- 貫通貼合わせ 4層~28層 + 4層~28層
ビルアップ基板(3-n-3)

高多層貼合わせ+ビルアップ基板(1-n+n-1)












